क्यू आर संहिता

हमारे बारे में
उत्पादों
संपर्क करें


फैक्स
+86-579-87223657


पता
वांग्डा रोड, ज़ियांग स्ट्रीट, वुयी काउंटी, जिंहुआ शहर, झेजियांग प्रांत, चीन
सीवीडी टीएसी कोटिंगउच्च शक्ति, संक्षारण प्रतिरोध और अच्छे रासायनिक स्थिरता के साथ एक महत्वपूर्ण उच्च तापमान संरचनात्मक सामग्री है। इसका पिघलने बिंदु 3880 ℃ के रूप में अधिक है, और यह उच्चतम तापमान प्रतिरोधी यौगिकों में से एक है। इसमें उत्कृष्ट उच्च तापमान वाले यांत्रिक गुण, उच्च गति वाले एयरफ्लो कटाव प्रतिरोध, एब्लेशन प्रतिरोध, और ग्रेफाइट और कार्बन/कार्बन समग्र सामग्री के साथ अच्छे रासायनिक और यांत्रिक संगतता हैं।
इसलिए, मेंMOCVD एपिटैक्सियल प्रक्रियागण एलईडी और sic बिजली उपकरणों की,सीवीडी टीएसी कोटिंगH2, HC1, और NH3 के लिए उत्कृष्ट एसिड और क्षार प्रतिरोध है, जो ग्रेफाइट मैट्रिक्स सामग्री को पूरी तरह से रक्षा कर सकता है और विकास के वातावरण को शुद्ध कर सकता है।
CVD TAC कोटिंग अभी भी 2000 ℃ से ऊपर स्थिर है, और CVD TAC कोटिंग 1200-1400 ℃ पर विघटित होने लगती है, जो ग्रेफाइट मैट्रिक्स की अखंडता में भी सुधार करेगा। बड़े संस्थान सभी सीवीडी का उपयोग ग्रेफाइट सब्सट्रेट पर सीवीडी टीएसी कोटिंग तैयार करने के लिए करते हैं, और एसआईसी पावर डिवाइसेस और गेनल्ड्स एपिटैक्सियल उपकरणों की जरूरतों को पूरा करने के लिए सीवीडी टीएसी कोटिंग की उत्पादन क्षमता को और बढ़ाएंगे।
सीवीडी टीएसी कोटिंग की तैयारी प्रक्रिया आम तौर पर सब्सट्रेट सामग्री के रूप में उच्च घनत्व ग्रेफाइट का उपयोग करती है, और दोष-मुक्त तैयार करती हैसीवीडी टीएसी कोटिंगसीवीडी विधि द्वारा ग्रेफाइट सतह पर।
सीवीडी टीएसी कोटिंग को तैयार करने के लिए सीवीडी विधि की प्राप्ति प्रक्रिया निम्नानुसार है: वाष्पीकरण कक्ष में रखा गया ठोस टैंटलम स्रोत एक निश्चित तापमान पर गैस में सूजन करता है, और एआर वाहक गैस की एक निश्चित प्रवाह दर द्वारा वाष्पीकरण कक्ष से बाहर ले जाया जाता है। एक निश्चित तापमान पर, गैसीय टैंटलम स्रोत एक कमी प्रतिक्रिया से गुजरने के लिए हाइड्रोजन के साथ मिलता है और मिल जाता है। अंत में, कम टैंटलम तत्व को बयान कक्ष में ग्रेफाइट सब्सट्रेट की सतह पर जमा किया जाता है, और एक निश्चित तापमान पर एक कार्बनकरण प्रतिक्रिया होती है।
सीवीडी टीएसी कोटिंग की प्रक्रिया में वाष्पीकरण तापमान, गैस प्रवाह दर, और बयान तापमान जैसे प्रक्रिया मापदंडों के गठन में एक बहुत महत्वपूर्ण भूमिका निभाते हैंसीवीडी टीएसी कोटिंग। और मिश्रित अभिविन्यास के साथ सीवीडी टीएसी कोटिंग को एक TACL5 -H2 -AR -C3H6 प्रणाली का उपयोग करके 1800 ° C पर इज़ोटेर्मल रासायनिक वाष्प बयान द्वारा तैयार किया गया था।
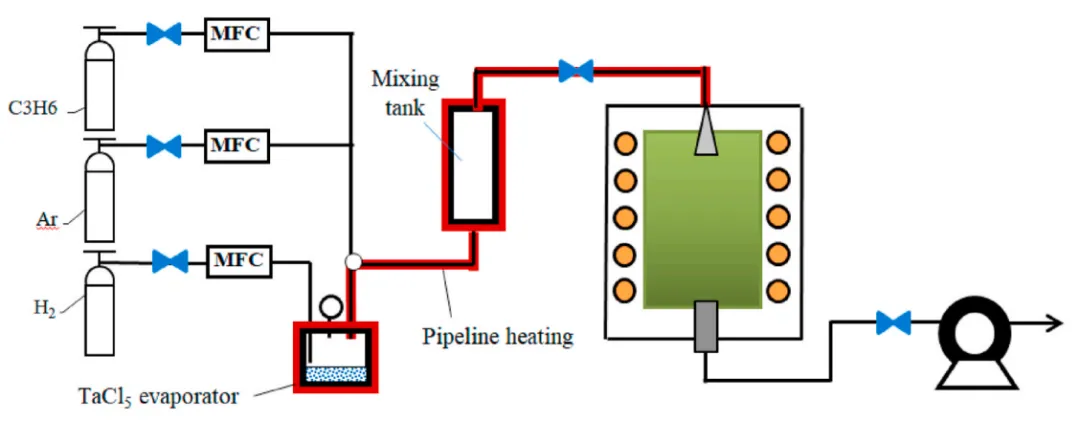
चित्रा 1 रासायनिक वाष्प जमाव (सीवीडी) रिएक्टर और टीएसी बयान के लिए संबंधित गैस वितरण प्रणाली के विन्यास को दर्शाता है।
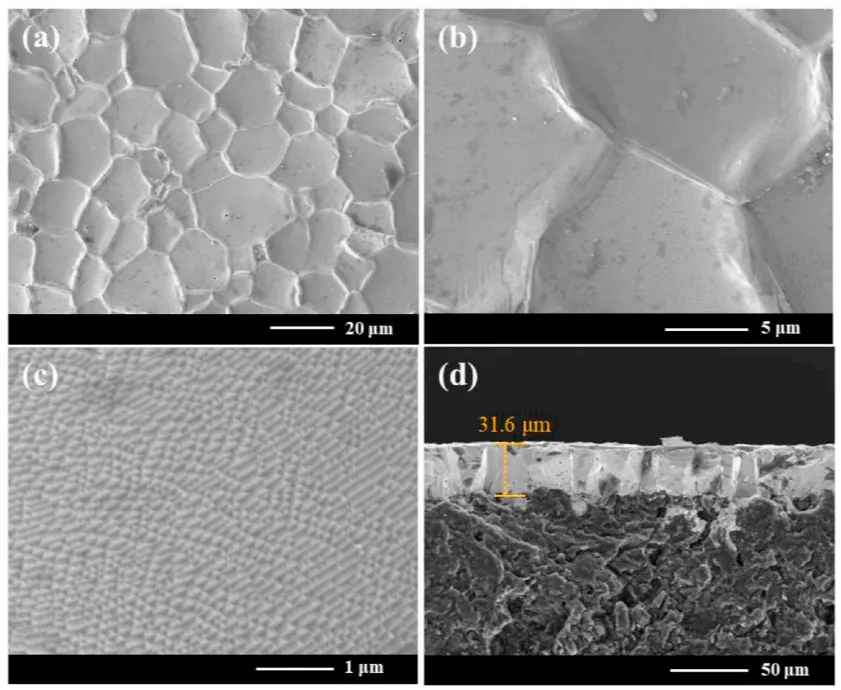
चित्रा 2 विभिन्न परिमाणों पर सीवीडी टीएसी कोटिंग की सतह आकृति विज्ञान को दर्शाता है, जिसमें कोटिंग के घनत्व और अनाज के आकारिकी को दिखाया गया है।

चित्रा 3 केंद्रीय क्षेत्र में पृथक्करण के बाद सीवीडी टीएसी कोटिंग की सतह आकृति विज्ञान को दर्शाता है, जिसमें सतह पर गठित धुंधले अनाज की सीमाएं और द्रव पिघला हुआ ऑक्साइड शामिल हैं।

चित्रा 4 पृथक्करण के बाद विभिन्न क्षेत्रों में सीवीडी टीएसी कोटिंग के एक्सआरडी पैटर्न को दर्शाता है, एब्लेशन उत्पादों की चरण संरचना का विश्लेषण करता है, जो मुख्य रूप से β-TA2O5 और α-TA2O5 हैं।



+86-579-87223657


वांग्डा रोड, ज़ियांग स्ट्रीट, वुयी काउंटी, जिंहुआ शहर, झेजियांग प्रांत, चीन
कॉपीराइट © 2024 वूयी तियानयाओ एडवांस्ड मटेरियल टेक.कं., लिमिटेड। सर्वाधिकार सुरक्षित।
Links | Sitemap | RSS | XML | गोपनीयता नीति |
