क्यू आर संहिता

हमारे बारे में
उत्पादों
संपर्क करें


फैक्स
+86-579-87223657


पता
वांग्डा रोड, ज़ियांग स्ट्रीट, वुयी काउंटी, जिंहुआ शहर, झेजियांग प्रांत, चीन
वैश्विक ऊर्जा परिवर्तन, एआई क्रांति और नई पीढ़ी की सूचना प्रौद्योगिकियों की लहर के साथ, सिलिकॉन कार्बाइड (SiC) अपने असाधारण भौतिक गुणों के कारण तेजी से "संभावित सामग्री" से "रणनीतिक मूलभूत सामग्री" बन गया है। इसके अनुप्रयोग अभूतपूर्व गति से बढ़ रहे हैं, जो सब्सट्रेट सामग्री की गुणवत्ता और स्थिरता पर लगभग अत्यधिक मांग डाल रहे हैं। इसने "कार्बन एनकैप्सुलेशन" जैसे महत्वपूर्ण दोषों को संबोधित करना पहले से कहीं अधिक जरूरी और आवश्यक बना दिया है।
सीमांत अनुप्रयोग ड्राइविंग एसआईसी सबस्ट्रेट्स
1.एआई हार्डवेयर पारिस्थितिकी तंत्र और लघुकरण की सीमाएं:
एआई ग्लास (एआर/वीआर डिवाइस) की अगली पीढ़ी विसर्जन और वास्तविक समय की बातचीत की एक अद्वितीय भावना के लिए प्रयास करती है। इसका मतलब यह है कि उनके आंतरिक कोर प्रोसेसर (जैसे समर्पित एआई अनुमान चिप्स) को बड़ी मात्रा में डेटा संसाधित करना होगा और बेहद सीमित लघु स्थान के भीतर महत्वपूर्ण गर्मी अपव्यय को संभालना होगा। इस परिदृश्य में सिलिकॉन-आधारित चिप्स को भौतिक सीमाओं का सामना करना पड़ता है।
एआर/वीआर ऑप्टिकल वेवगाइड को डिवाइस की मात्रा कम करने के लिए उच्च अपवर्तक सूचकांक, पूर्ण-रंगीन डिस्प्ले का समर्थन करने के लिए ब्रॉड-बैंड ट्रांसमिशन, उच्च-शक्ति प्रकाश स्रोतों से गर्मी अपव्यय को प्रबंधित करने के लिए उच्च तापीय चालकता और स्थायित्व सुनिश्चित करने के लिए उच्च कठोरता और स्थिरता की आवश्यकता होती है। उन्हें बड़े पैमाने पर विनिर्माण के लिए परिपक्व सूक्ष्म/नैनो-ऑप्टिकल प्रसंस्करण प्रौद्योगिकियों के साथ भी संगत होना चाहिए।
SiC की भूमिका: SiC सबस्ट्रेट्स से बने GaN-on-SiC RF/पावर मॉड्यूल इस विरोधाभास को हल करने के लिए महत्वपूर्ण हैं। वे उच्च दक्षता के साथ लघु डिस्प्ले और सेंसर सिस्टम चला सकते हैं और सिलिकॉन की तुलना में कई गुना अधिक तापीय चालकता के साथ, चिप्स द्वारा उत्पन्न भारी गर्मी को जल्दी से खत्म कर सकते हैं, जिससे स्लिम फॉर्म फैक्टर में स्थिर संचालन सुनिश्चित होता है।
सिंगल-क्रिस्टल सिलिकॉन कार्बाइड (SiC) में उत्कृष्ट पारदर्शिता के साथ दृश्यमान प्रकाश स्पेक्ट्रम में लगभग 2.6 का अपवर्तक सूचकांक होता है, जो इसे उच्च-एकीकृत ऑप्टिकल वेवगाइड डिजाइनों के लिए उपयुक्त बनाता है। अपने उच्च अपवर्तक सूचकांक गुणों के आधार पर, एक एकल-परत SiC विवर्तन वेवगाइड सैद्धांतिक रूप से लगभग 70° के दृश्य क्षेत्र (FOV) को प्राप्त कर सकता है और इंद्रधनुष पैटर्न को प्रभावी ढंग से दबा सकता है। इसके अलावा, SiC में अत्यधिक उच्च तापीय चालकता (लगभग 4.9 W/cm·K) है, जो इसे ऑप्टिकल और यांत्रिक स्रोतों से गर्मी को तेजी से नष्ट करने की अनुमति देती है, जिससे तापमान वृद्धि के कारण ऑप्टिकल प्रदर्शन में गिरावट को रोका जा सकता है। इसके अतिरिक्त, SiC की उच्च कठोरता और पहनने का प्रतिरोध वेवगाइड लेंस की संरचनात्मक स्थिरता और दीर्घकालिक स्थायित्व को महत्वपूर्ण रूप से बढ़ाता है। SiC वेफर्स का उपयोग सूक्ष्म/नैनो प्रसंस्करण (जैसे नक़्क़ाशी और कोटिंग) के लिए किया जा सकता है, जिससे सूक्ष्म-ऑप्टिकल संरचनाओं के एकीकरण की सुविधा मिलती है।

"कार्बन एनकैप्सुलेशन" के खतरे: यदि SiC सब्सट्रेट में "कार्बन एनकैप्सुलेशन" दोष होता है, तो यह एक स्थानीयकृत "थर्मल इंसुलेटर" और "इलेक्ट्रिकल फॉल्ट पॉइंट" बन जाता है। यह न केवल गर्मी के प्रवाह को गंभीर रूप से बाधित करता है, जिससे चिप की स्थानीय ओवरहीटिंग और प्रदर्शन में गिरावट आती है, बल्कि यह माइक्रो-डिस्चार्ज या लीकेज धाराओं का कारण भी बन सकता है, जिससे संभावित रूप से दीर्घकालिक उच्च-लोड स्थितियों के तहत एआई ग्लास में विसंगतियां, गणना त्रुटियां या यहां तक कि हार्डवेयर विफलता भी हो सकती है। इसलिए, एक दोष-मुक्त SiC सब्सट्रेट विश्वसनीय, उच्च-प्रदर्शन पहनने योग्य AI हार्डवेयर प्राप्त करने के लिए भौतिक आधार है।
"कार्बन एनकैप्सुलेशन" के खतरे: यदि SiC सब्सट्रेट में "कार्बन एनकैप्सुलेशन" दोष होता है, तो यह सामग्री के माध्यम से दृश्य प्रकाश के संचरण को कम कर देगा, और वेवगाइड के स्थानीयकृत ओवरहीटिंग, प्रदर्शन में गिरावट और प्रदर्शन चमक में कमी या असामान्यता का कारण बन सकता है।
2.उन्नत कंप्यूटिंग पैकेजिंग में क्रांति:
NVIDIA के नेतृत्व में AI कंप्यूटिंग पावर रेस में, CoWoS (चिप-ऑन-वेफर-ऑन-सब्सट्रेट) जैसी उन्नत पैकेजिंग प्रौद्योगिकियां सीपीयू, जीपीयू और एचबीएम मेमोरी को एकीकृत करने के लिए केंद्रीय बन गई हैं, जिससे कंप्यूटिंग पावर में तेजी से वृद्धि हो रही है। इस जटिल विषम एकीकरण प्रणाली में, इंटरपोजर उच्च गति इंटरकनेक्ट और थर्मल प्रबंधन के लिए रीढ़ की हड्डी के रूप में एक महत्वपूर्ण भूमिका निभाता है।
SiC की भूमिका: सिलिकॉन और ग्लास की तुलना में, SiC को इसकी अत्यधिक उच्च तापीय चालकता, थर्मल विस्तार का गुणांक जो चिप्स के साथ बेहतर मेल खाता है, और उत्कृष्ट विद्युत इन्सुलेशन गुणों के कारण अगली पीढ़ी के उच्च-प्रदर्शन इंटरपोज़र के लिए आदर्श सामग्री माना जाता है। SiC इंटरपोज़र्स कई कंप्यूटिंग कोर से केंद्रित गर्मी को अधिक कुशलता से नष्ट कर सकते हैं और हाई-स्पीड सिग्नल ट्रांसमिशन की अखंडता सुनिश्चित कर सकते हैं।
"कार्बन एनकैप्सुलेशन" के खतरे: नैनोमीटर-स्तरीय इंटरकनेक्ट के नीचे, एक माइक्रोन-स्तरीय "कार्बन एनकैप्सुलेशन" दोष "टाइम बम" की तरह है। यह स्थानीय थर्मल और तनाव क्षेत्रों को विकृत कर सकता है, जिससे थर्मोमैकेनिकल थकान हो सकती है और इंटरकनेक्ट धातु परतों में दरार पड़ सकती है, जिससे सिग्नल में देरी, क्रॉसस्टॉक या पूर्ण विफलता हो सकती है। सैकड़ों-हजारों आरएमबी मूल्य के एआई एक्सेलेरेशन कार्ड में, अंतर्निहित सामग्री दोषों के कारण होने वाली सिस्टम विफलताएं अस्वीकार्य हैं। SiC इंटरपोज़र की पूर्ण शुद्धता और संरचनात्मक पूर्णता सुनिश्चित करना संपूर्ण जटिल कंप्यूटिंग प्रणाली की विश्वसनीयता बनाए रखने की आधारशिला है।
निष्कर्ष: "स्वीकार्य" से "पूर्ण और दोषरहित" में संक्रमण। अतीत में, सिलिकॉन कार्बाइड का उपयोग मुख्य रूप से औद्योगिक और ऑटोमोटिव क्षेत्रों में किया जाता था, जहां दोषों के प्रति कुछ सहनशीलता मौजूद थी। हालाँकि, जब AI ग्लास और NVIDIA के CoWoS जैसे अल्ट्रा-हाई-वैल्यू, अल्ट्रा-कॉम्प्लेक्स सिस्टम की लघुकरण दुनिया की बात आती है, तो भौतिक दोषों के लिए सहनशीलता शून्य हो गई है। प्रत्येक "कार्बन एनकैप्सुलेशन" दोष सीधे अंतिम उत्पाद की प्रदर्शन सीमा, विश्वसनीयता और व्यावसायिक सफलता को खतरे में डालता है। इसलिए, "कार्बन एनकैप्सुलेशन" जैसे सब्सट्रेट दोषों पर काबू पाना अब केवल एक अकादमिक या प्रक्रिया सुधार का मुद्दा नहीं है, बल्कि एक महत्वपूर्ण सामग्री लड़ाई है जो अगली पीढ़ी की कृत्रिम बुद्धिमत्ता, उन्नत कंप्यूटिंग और उपभोक्ता इलेक्ट्रॉनिक्स क्रांति का समर्थन करती है।
कार्बन रैपिंग कहाँ से आती है?
रोस्ट एट अल. "एकाग्रता मॉडल" का प्रस्ताव दिया, जिसमें सुझाव दिया गया कि गैस चरण में पदार्थों के अनुपात में परिवर्तन कार्बन एनकैप्सुलेशन का मुख्य कारण है। ली एट अल. पाया गया कि बीज ग्राफिटाइजेशन विकास शुरू होने से पहले कार्बन एनकैप्सुलेशन को प्रेरित कर सकता है। क्रूसिबल से सिलिकॉन-समृद्ध वातावरण के निकलने और सिलिकॉन वातावरण और ग्रेफाइट क्रूसिबल और अन्य ग्रेफाइट तत्वों के बीच सक्रिय संपर्क के कारण, सिलिकॉन कार्बाइड स्रोत का ग्रेफाइटीकरण अपरिहार्य है। इसलिए, विकास कक्ष में अपेक्षाकृत कम सी आंशिक दबाव कार्बन एनकैप्सुलेशन का मुख्य कारण हो सकता है। हालाँकि, एवरोव एट अल। तर्क दिया कि कार्बन एनकैप्सुलेशन सिलिकॉन की कमी के कारण नहीं होता है। इस प्रकार, अतिरिक्त सिलिकॉन के कारण ग्रेफाइट तत्वों का मजबूत क्षरण कार्बन समावेशन का मुख्य कारण हो सकता है। इस पेपर में प्रत्यक्ष प्रायोगिक साक्ष्य से पता चलता है कि स्रोत सतह पर महीन कार्बन कणों को सिलिकॉन कार्बाइड एकल क्रिस्टल के विकास के मोर्चे पर ले जाया जा सकता है, जिससे कार्बन एनकैप्सुलेशन बनता है। यह परिणाम इंगित करता है कि विकास कक्ष में महीन कार्बन कणों का उत्पादन कार्बन एनकैप्सुलेशन का प्राथमिक कारण है। सिलिकॉन कार्बाइड एकल क्रिस्टल में कार्बन एनकैप्सुलेशन की उपस्थिति विकास कक्ष में सी के कम आंशिक दबाव के कारण नहीं है, बल्कि सिलिकॉन कार्बाइड स्रोत के ग्रेफाइटाइजेशन और ग्रेफाइट तत्वों के क्षरण के कारण कमजोर रूप से जुड़े कार्बन कणों के गठन के कारण है।
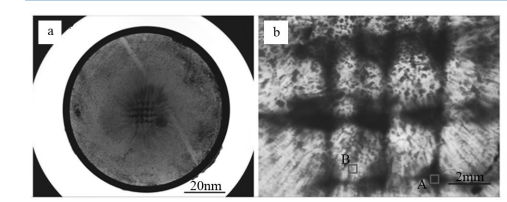
समावेशन का वितरण स्रोत सतह पर ग्रेफाइट प्लेटों के पैटर्न से काफी मिलता-जुलता प्रतीत होता है। एकल क्रिस्टल वेफर्स में समावेश-मुक्त क्षेत्र गोलाकार होते हैं, जिनका व्यास लगभग 3 मिमी होता है, जो छिद्रित गोलाकार छिद्रों के व्यास से पूरी तरह मेल खाता है। इससे पता चलता है कि कार्बन एनकैप्सुलेशन कच्चे माल के क्षेत्र से उत्पन्न होता है, जिसका अर्थ है कि कच्चे माल का ग्राफ़िटाइजेशन कार्बन एनकैप्सुलेशन दोष का कारण बनता है।
सिलिकॉन कार्बाइड क्रिस्टल विकास के लिए आमतौर पर 100-150 घंटे की आवश्यकता होती है। जैसे-जैसे विकास आगे बढ़ता है, कच्चे माल का रेखांकन अधिक गंभीर होता जाता है। मोटे क्रिस्टल उगाने की मांग के तहत, कच्चे माल के ग्रेफाइटाइजेशन को संबोधित करना एक प्रमुख मुद्दा बन जाता है।
कार्बन रैपिंग समाधान
1. प्राइवेट में कच्चे माल का उर्ध्वपातन सिद्धांत

जैसा कि उपरोक्त चित्र में देखा गया है, कच्चे माल के कण आकार को बढ़ाने से कच्चे माल में सी घटक के अधिमान्य अस्थिरता को दबाने में मदद मिलती है, जिससे संपूर्ण विकास प्रक्रिया के दौरान गैस चरण संरचना अधिक स्थिर हो जाती है और कच्चे माल के ग्राफिटाइजेशन मुद्दे का समाधान हो जाता है। बड़े कण सीवीडी सामग्री, विशेष रूप से 8 मिमी से बड़े आकार के कच्चे माल से ग्रेफाइटाइजेशन समस्या को पूरी तरह से हल करने की उम्मीद है, जिससे सब्सट्रेट में कार्बन एनकैप्सुलेशन दोष समाप्त हो जाएगा।
निष्कर्ष और संभावना

सीवीडी विधि द्वारा संश्लेषित बड़े-कण, उच्च-शुद्धता, स्टोइकोमेट्रिक SiC कच्चा माल, इसके अंतर्निहित कम सतह क्षेत्र से आयतन अनुपात के साथ, PVT विधि का उपयोग करके SiC एकल क्रिस्टल विकास के लिए एक अत्यधिक स्थिर और नियंत्रणीय उच्च बनाने की क्रिया स्रोत प्रदान करता है। यह न केवल कच्चे माल के रूप में बदलाव है, बल्कि पीवीटी विधि के थर्मोडायनामिक और गतिज वातावरण को मौलिक रूप से नया आकार और अनुकूलन भी देता है।
एप्लिकेशन के फायदे सीधे इसमें अनुवादित हैं:



+86-579-87223657


वांग्डा रोड, ज़ियांग स्ट्रीट, वुयी काउंटी, जिंहुआ शहर, झेजियांग प्रांत, चीन
कॉपीराइट © 2024 वूयी तियानयाओ एडवांस्ड मटेरियल टेक.कं., लिमिटेड। सर्वाधिकार सुरक्षित।
Links | Sitemap | RSS | XML | गोपनीयता नीति |
